Лекция
Привет, Вы узнаете о том , что такое рентгенолитография, Разберем основные их виды и особенности использования. Еще будет много подробных примеров и описаний. Для того чтобы лучше понимать что такое рентгенолитография, рентгеновская литография , настоятельно рекомендую прочитать все из категории Конструирование и проектирование электронной аппаратуры.
рентгеновская литография — технология изготовления электронных микросхем; вариант фотолитографии, использующий экспонирование (облучение) резиста с помощью рентгеновских лучей.
Рентгеновская литография использует мягкое рентгеновское излучения с длиной волны 0.4-5.0 нм. Пучок рентгеновских лучей пропускается через шаблон и экспонирует слой резиста. Оптическими элементами рентгеновских литографических установок могут быть отражающие зеркала (рефлекторы) на основе наногетероструктур со слоями Ni-C, Cr-C, Co-C, Mo-C, W-C и зонные пластинки; в качестве шаблонов используются тонкие (1 мкм и меньше) металлические мембраны. Многослойные рентгеновские зеркала обеспечивают брэгговское отражение при условии d = λ/(2sinΘ), где d — период структуры и Θ — угол скольжения. При перпендикулярном падении излучения Θ = 90° и период d = λ/2, поэтому толщина каждого слоя в рентгеновском зеркале равна примерно λ/4 или 1 нм.
рентгенолитография , как и оптическая литография, осуществляется путем одновременного экспонирования большого числа деталей рисунка, но коротковолновое рентгеновское излучение позволяет создавать рисунок с более тонкими деталями и более высоким разрешением.
Благодаря малой длине волны рентгеновского излучения методы рентгенолитографии обладают высокой разрешающей способностью (~ 10 нм). По сравнению с электронно-лучевой и ионно-лучевой литографией в рентгеновской литографии малы радиационные повреждения формируемых структур и высока производительность благодаря возможности одновременной обработки больших площадей образца. Рентгеновская литография отличается большой глубиной резкости и малым влиянием материала подложки и ее топографии на разрешающую способность.
Рентгенолитография как и электронолитография устраняет дифракционные ограничения излучения. Для экспонирования используют "мягкие" рентгеновские лучи длиной волны 0,4 - 50 нм, возбуждаемые с помощью интенсивных электронных пучков. Рассеяние рентгеновских квантов в подложке намного меньше, чем рассеяние электронов, которое ограничивает возможную разрешающую способность электронолитографии. Такие достоинства, как высокая разрешающая способность (менее 0,01 мкм), большая глубина резкости (до десятков микрометров), обеспечивающая экспонирование с большим зазором и, следовательно, долговечность шаблонов, малая чувствительность к частицам пыли и другим загрязнениям, нечувствительность к внешним магнитным и электрическим полям, делают рентгенолитографию одним из самых надежных методов создания ИМС с высокой плотностью упаковки.
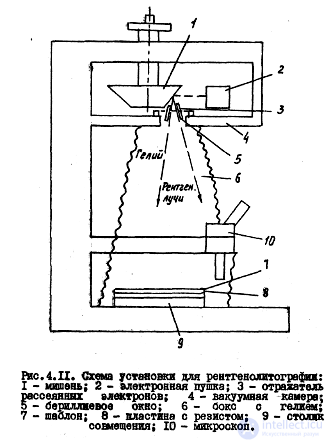
На рис.4.11 показана схема установки для рентгенолитографии.

1 - электронная пушка:
2 - магнитная фокусирующая система:
3 - электронный луч:
4 - охлаждаемый анод;
5 - юстировочное устройство;
6 - неподвижный анод - излучатель;
7 - камера источника;
8 - рентгеновский луч;
9 - затвор;
10 -выходное окно;
11 - рентгеновский шаблон;
12 - камера экспонирования;
13 - подложка;
14 - спутник;
15 -натекатель;
16 - шлюзовой затвор:
17 - шлюзовая камера.
Рентгеновское излучение получают путем воздействия на мишень сфокусированным пучком электронов. В качестве мишени используют различные металлы.(Табл 4.1)
Пучок электронов, направляемый электронной пушкой, фокусируется на мишени. Для того чтобы обеспечить достаточно мор.ный поток рентгеновского излучения, необходимо охлаждать мишень водой и вращать с большой скоростью (иначе она расплавится); этот узел является'слабым местом'рентгенолитографических установок. Типичные системы тлеют диаметр мишени около 10 см, мощность электронного пучка 10 - 25 кВт, .диаметр пучка несколько миллиметров, расстояние от мишени до резиста изменяется от 15 до 50 см. Рентгеновский пучок проходит отражатель рассеянных электронов и выводится из вакуумной камеры через тонкое берйллиевое окно. В наполненном гелием (ослабление рентгеновского излучения в гелии намного больше, чем в воздухе) боксе находится шаблон и пластина с резистом, укрепленные на столике совмещения. Совмещение осуществляется несколькими способами, простейший из которых - оптический, с помощью микроскопа с большим увеличением.
Теоретический предел разрешающей способности рентгенолитографии составляет менее 0,1 мкм. На практике достичь его пока не удается. Это связано, во-первых, с появлением фотоэлектронов, рождаемых рентгеновским излучением, которые вызывают расширение
линии примерно на 100 нм, и,во-вторых, с двумя формами искажений, возникающих при экспонировании.


Укажем причины этих искажений:
I. Если источник рентгеновского излучения протяженный, то возникает полутеневая дисторсия. На рис.4.12 показана диаграмма искажения для этого случая. Дисторсия может быть определена по формуле:
 (4.9)
(4.9)
где S - зазор между шаблоном и пластиной; d- длина источника излучения; D - расстояние между источником излучения и шаблоном.
Ввиду малой механической прочности рентгеношаблона зазор между пластиной и шаблоном является необходимой мерой.
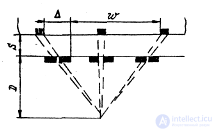
Рис.4.13. Диаграмма искажения изображения при точечном источнике рентгеновских лучей.
Субмикронная печать обеспечивается при зазоре шаблон пластина порядка 1 мкм. Искривления пластины, возникающие в ходе многих стандартных технологических процессов, делает такой зазор трудно достижимым.
Ошибки, связанные с зазором, можно отчасти устранить, если перейти к пошаговому экспонированию либо повысить чувствительность резиста до 1 мДж/см2, что позволит удалить источник излучения от пластины. Главные трудности связаны с термостабильностью шаблона, так как нагрев шаблона экспонирующем излучением приводит к изменению размеров элементов в плане и ошибкам совмещения.
Из-за малого поглощения время рентгеновского экспонирования чрезвычайно велико. Первыми шагами к совершенствованию рентгеновской печати (с зазором) является создание:
1) высокочувствительных резистов;
2) интенсивного источника;
3) точной и надежной системы совмещения;
4) прозрачного и стабильного шаблонов.
2. При точечном источнике возникает геометрическая дисторсия (рис.4.13). Величина геометрической дисторсии определяется по формуле:
 (4.10)
(4.10)
где W - ширина (диаметр) пластины полупроводника. Такая дисторсия может быть учтена при проектировании маски, если все параметры, входящие в формулу (4.10), сохраняются постоянными. Наиболее сложно выдержать постоянным зазор между шаблоном и пластиной.
Выбор длины волны рентгеновского излучения, вещества маски шаблона, через который проводится экспонирование рентгенорезиста, взаимосвязаны.
Выбор материала мишени, а следовательно, длины волны рентгеновского излучения, осуществляется с учетом того, что к рентгеновским лучам низкой энергии (большая длина волны) фоторезисты очень чувствительны, однако такое излучение сильно поглощается материалом шаблона. Об этом говорит сайт https://intellect.icu . Жесткое рентгеновское излучение не эффективно поглощается фоторезистом (менее 5%) и, кроме того, требуются более толстые слои поглощающего покрытия шаблона (см. табл.4.1), что в свою очередь снижает возможность получения малых изображений.
Создание рентгеношаблона является серьезной проблемой данного метода литографии. Поглощающая пленка должна иметь резкие края, быть тонкой и значительно ослаблять рентгеновское излучение. Для этой цели используют тонкие пленки золота, платины, рения, европия. Подложка для шаблона (мембрана) должна быть механически прочной и пропускать как можно большую долю падающего излучения. В качестве мембраны используют пленки различных неорганических материалов, включая  , а также полимеры майлар и полиимид. Толщина мембраны зависит от длины волны излучения и составляет обычно несколько микрометров. При использовании источников длиной волны менее 1,33 нм мембрана интенсивно поглощает излучение и поэтому ее толщину необходимо уменьшить до I мкм (см. табл.4.1).
, а также полимеры майлар и полиимид. Толщина мембраны зависит от длины волны излучения и составляет обычно несколько микрометров. При использовании источников длиной волны менее 1,33 нм мембрана интенсивно поглощает излучение и поэтому ее толщину необходимо уменьшить до I мкм (см. табл.4.1).
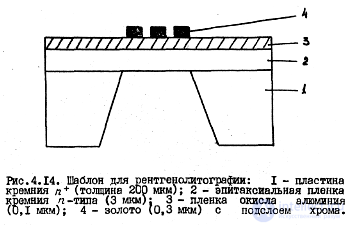
Шаблон из кремния (рис.4.14) представляет собой пластину с утоненными окнами-мембранами. Мембрана и подложка, на которой они формируются, состоят из одного материала и, следовательно, имеют один коэффициент термического расширения. Изготовление начинается с эпитаксиального выращивания слаболегированного слояn-типа на сильнолегированной n+ подложке, на которую наносится тонкий слой Al2O3. Поглощающая маска создается на поверхности этого слоя методом элекронолиографии. Затем идет наиболее ответственная операция - медленное травление окон в n+ кремниевой подложке (площадь окон около 1 см2 ).
Некоторым преимуществом перед кремниевыми масками обладают маски из тонкой полимерной пленки, натянутой на поддерживающем кольце из стали или алюминия.
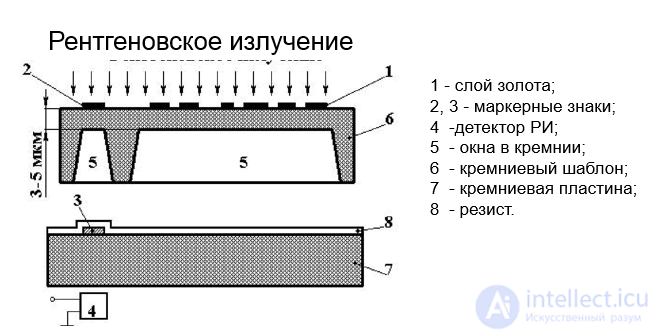
Одной из серьезных проблем в рентгенолитографли является деформация шаблона при изготовлении и эксплуатации. Причинами деформации могут быть механические напряжения в мембране или разные температурные коэффициенты расширения мембраны и основания шаблона.
Для устранения недостатков, связанных с дисторсией и большим временем экспонирования в процессе рентгенолитографии, предлагается использовать синхротронное излучение. Оно генерируется релятивистскими электронами при их движении по криволинейным траекториям в магнитных полях. Но касательной к траектории движения электронов, ускоренных до I ГэВ, можно получить мощный плоскопараллельный пучок рентгеновского излучения широкого спектра. Этим методом получены линии шириной 0,05мкм. Недостатком процесса является использование дорогостоящего оборудования и сложность его эксплуатации.
Рентгеновская литография зародилась как кандидат на литографию нового поколения для полупроводниковой промышленности , и были успешно произведены партии микропроцессоров . Обладая короткими длинами волн (менее 1 нм), рентгеновские лучи преодолевают дифракционные пределы оптической литографии , обеспечивая меньшие размеры элементов. Если источник рентгеновского излучения не коллимирован, как в случае с синхротронным излучением , то вместо преломляющих линз используются элементарные коллимирующие зеркала или дифракционные линзы.линзы, используемые в оптике. Рентгеновские лучи освещают маску, расположенную рядом с пластиной, покрытой резистом. Рентгеновское излучение является широкополосным, обычно от компактного источника синхротронного излучения , что обеспечивает быстрое облучение. Глубокая рентгеновская литография (DXRL) использует еще более короткие длины волн, порядка 0,1 нм, и модифицированные процедуры, такие как процесс LIGA , для создания глубоких и даже трехмерных структур.
Маска состоит из поглотителя рентгеновского излучения, обычно из золота или соединений тантала или вольфрама , на мембране, прозрачной для рентгеновских лучей, обычно из карбида кремния или алмаза . Рисунок на маске наносится методом электронной литографии с прямой записью на резист, который создается с помощью обычных полупроводниковых процессов. Мембрану можно растягивать для точности наложения.
Большинство демонстраций рентгеновской литографии было выполнено путем копирования с точностью изображения (без увеличения) по линии нечеткого контраста, как показано на рисунке. Однако с возрастающей потребностью в высоком разрешении рентгеновская литография теперь выполняется в так называемом «золотом пятне», используя локальное «уменьшение смещения». Плотные структуры создаются путем многократного воздействия с переводом. Преимущества использования 3-кратного уменьшения включают в себя более легкое изготовление маски, увеличение зазора между маской и пластиной и более высокую контрастность. Технология расширяется до плотных отпечатков 15 нм .
Рентгеновские лучи генерируют вторичные электроны, как в случае литографии в крайнем ультрафиолете и электронно-лучевой литографии . В то время как четкое определение структуры обусловлено в основном вторичными частицами от оже-электронов с коротким пробегом, первичные электроны будут сенсибилизировать резист в большей области, чем воздействие рентгеновских лучей. Хотя это не влияет на разрешение шага рисунка, которое определяется длиной волны и зазором, контраст экспозиции изображения (макс-мин) / (макс + мин) уменьшается, потому что шаг составляет порядок первичного фотоэлектронного диапазона. Эти вторичные электроны влияют на шероховатость и наклон боковых стенок, поскольку они могут перемещаться на несколько микрометров в области под поглотителем, в зависимости от энергии рентгеновского излучения. Былоопубликованонесколько отпечатков толщиной около 30 нм .
Еще одно проявление фотоэлектронного эффекта - воздействие рентгеновских лучей на электроны из толстых золотых пленок, используемых для изготовления дочерних масок. Моделирование показывает, что генерация фотоэлектронов на золотой подложке может влиять на скорость растворения.
Вторичные электроны имеют энергию 25 эВ или меньше и могут генерироваться любым ионизирующим излучением ( ВУФ , ЭУФ, рентгеновскими лучами, ионами и другими электронами). Энергия оже-электронов составляет сотни электронвольт. Вторичные компоненты (генерируемые оже- и первичными фотоэлектронами и превосходящие их по численности) являются основными агентами сопротивления экспонированию.
Относительные пробеги первичных фотоэлектронов и оже-электронов зависят от их соответствующих энергий. Эти энергии зависят от энергии падающего излучения и от состава резиста. Есть много возможностей для оптимального выбора (ссылка 3 статьи). Когда оже-электроны имеют более низкую энергию, чем первичные фотоэлектроны, они имеют более короткий пробег. Оба распадаются на вторичные компоненты, которые взаимодействуют с химическими связями. Когда вторичные энергии слишком низкие, они не могут разорвать химические связи и перестают влиять на разрешение печати. Эксперименты доказывают, что комбинированный диапазон составляет менее 20 нм. С другой стороны, вторичные компоненты имеют другую тенденцию ниже ≈30 эВ: чем ниже энергия, тем больше длина свободного пробега. хотя тогда они не могут повлиять на развитие резиста.
По мере распада первичные фотоэлектроны и оже-электроны в конечном итоге становятся физически неотличимыми (как в статистике Ферми – Дирака ) от вторичных электронов. Диапазон вторичных электронов низкой энергии иногда больше, чем диапазон первичных фотоэлектронов или оже-электронов. Что важно для рентгеновской литографии, так это эффективный диапазон электронов, которые обладают достаточной энергией, чтобы создавать или разрывать химические связи в отрицательных или положительных резистах.

Рентгеновские лучи не заряжаются. Относительно большая длина свободного пробега (~ 20 нм) вторичных электронов затрудняет контроль разрешения в нанометровом масштабе. В частности, электронно-лучевая литография страдает от отрицательного заряда падающими электронами и, как следствие, разлета луча, что ограничивает разрешение. Поэтому трудно выделить эффективный диапазон вторичных компонентов, который может быть меньше 1 нм.
Комбинированная длина свободного пробега электронов приводит к размытию изображения, которое обычно моделируется как функция Гаусса (где σ = размытие), которая сворачивается с ожидаемым изображением. Когда желаемое разрешение приближается к размытию, дозовое изображение становится шире, чем аэрофотоснимок падающих рентгеновских лучей. Размытие, которое имеет значение, - это скрытое изображение, которое описывает создание или разрыв связей во время экспонирования резиста. Развитое изображением является окончательным рельефным изображением получает с помощью выбранного процесса развития высокого контраста на скрытом изображении.
В соответствии с различными цитируемыми публикациями диапазон первичных, оже-, вторичных и сверхнизкоэнергетических электронов генерации высшего порядка, которые печатают (как показали исследования СТМ ), может быть большим (десятки нм) или маленьким (нм). Поскольку этот диапазон не является фиксированным числом, его трудно определить количественно. Шероховатость кромки линии усугубляется связанной с этим неопределенностью. Шероховатость кромки линии предположительно имеет статистическое происхождение и лишь косвенно зависит от среднего диапазона. В обычных условиях литографии можно контролировать и использовать различные диапазоны электронов.
Рентгеновские лучи не несут заряда, но при указанных энергиях оже-распад ионизированных частиц в образце более вероятен, чем радиационный распад. Излучение высокой энергии, превышающее потенциал ионизации, также генерирует свободные электроны, которых можно пренебречь по сравнению с электронами, создаваемыми заряженными электронными лучами. Зарядка образца после ионизации является крайне слабой возможностью, когда нельзя гарантировать, что ионизированные электроны, покидающие поверхность или остающиеся в образце, адекватно сбалансированы от других источников во времени. Передача энергии электронам в результате ионизирующего излучения приводит к разделению положительных и отрицательных зарядов, которые быстро рекомбинируют, отчасти из-за дальнего действия кулоновской силы. Изоляционные пленки, такие как оксиды затвора и резисты, заряжаются до положительного или отрицательного потенциала при облучении электронным пучком. Изолирующие пленки в конечном итоге локально нейтрализуются пространственным зарядом (электроны, входящие и выходящие из поверхности) на границе резист-вакуум и Инъекция Фаулера-Нордхейма из субстрата. На пробег электронов в пленке может влиять местное электрическое поле. Ситуация осложняется наличием дырок (положительно заряженных электронных вакансий), которые генерируются вместе с вторичными электронами и которые, как можно ожидать, будут следовать за ними. По мере нейтрализации любая начальная концентрация заряда начинает эффективно распространяться. Окончательное химическое состояние пленки достигается после завершения нейтрализации, когда все электроны в конечном итоге замедляются. Обычно, за исключением шаговых двигателей с рентгеновским излучением, зарядку можно дополнительно контролировать с помощью пистолета-распылителя или слоя сопротивления или слоя рассеивания заряда.
Длина волны и энергия излучения для различных материалов анода - излучателя
|
Материал |
Длина волны, нм |
Е, кэВ |
|
Pd |
0,44 |
2,83 |
|
Mo |
0,54 |
2,29 |
|
Si |
0,71 |
1,74 |
|
Al |
0,88 |
1,49 |
|
Сu |
1,33 |
0,93 |
|
С |
4,47 |
0,28 |
МАКСИМАЛЬНАЯ МОЩНОСТЬ ИСТОЧНИКОВ РЕНТГЕНОВСКОГО ИЗЛУЧЕНИЯ
1. Для неподвижного анода:

Tm-температура плавления материала, То-температура охлаждающей жидкости на выходе, λ -теплопроводность материала анода, r - радиус электронного пятна
2. Для вращающегося анода:

r2=0,5 см, r1=0,05 см, у- плотность материала, с -удельная теплоемкость материала, V -линейная скорость перемещения пятна (20 м/с при диаметре
анода 100 - 300 мм)
СРАВНИТЕЛЬНЫЕ ХАРАКТЕРИСТИКИ ИСТОЧНИКОВ РЕНТГЕНОВСКОГО ИЗЛУЧЕНИЯ
1. Точечные источники с электронным возбуждением: Руд. < 1 мВт/ см2
2. Точечные источники с плазменным возбуждением: Руд. - 5 мВт/ см2
3. Электроразрядные плазменные источники Руд. -15 мВт/см2
4. Источники синхротронного излучения Руд. -400 мВт/ см2
МАТЕРИАЛЫ И ХАРАКТЕРИСТИКИ ШАБЛОНОВ ДЛЯ РЕНТГЕНОЛИТОГРАФИИ
|
Материал |
Толщина, мкм |
Поддерживающая конструкция |
Диаметр окна, см |
Длина волны, нм |
|
Кремний |
2...4 |
Рамка из Si |
до 5 |
0,83 |
|
Бериллий |
12 |
Металлическое кольцо |
2...S |
0,4...0.83 |
|
Нитрид кремния |
0,2.-.0,5 |
Рамка из Si |
до 1 |
0,83...1,33 |
|
Оксид алюминия |
0,2 |
Рамка из AI |
до 10 |
0.83...1.45 |
|
Майлар |
3...6 |
Стеклянное или металлическое кольцо |
до 10 |
1,33 |
|
Полиимид |
ТРЕБОВАНИЯ К ШАБЛОНАМ ДЛЯ РЕНТГЕНОЛИТОГРАФИИ
1. Прозрачность в диапазоне длин волн рентгеновского излучения 1,0-1,3 нм > 50 %;
2. Прозрачность в видимом диапазоне > 50 %;
3. Коэффициент контрастности 10;
4. Погрешность по толщине ± 50 нм;
5. Стабильность параметров во времени (стойкость к радиационным повреждениям, изменениям структуры, отсутствие механических напряжений в мембране).
Преимущества
0,05 мкм для Сu - мишени;
0,1 мкм для AI - мишени
2. Отсутствие контакта с резистом
3. Нечувствительность к внешним электрическим и магнитным полям
4. Отсутствие проблем, связанных с отражением и рассеянием излучения
5. Работа с пластинами не в вакууме
6. Простота и низкая стоимость по сравнению с электронолитографией
Недостатки
1. Большое время экспонирования (до 20 минут).
2. Дисторсия изображения на шаблоне из-за механических напряжений в пленках золота.
3. Высокая стоимость шаблонов.
Исследование, описанное в статье про рентгенолитография, подчеркивает ее значимость в современном мире. Надеюсь, что теперь ты понял что такое рентгенолитография, рентгеновская литография и для чего все это нужно, а если не понял, или есть замечания, то не стесняйся, пиши или спрашивай в комментариях, с удовольствием отвечу. Для того чтобы глубже понять настоятельно рекомендую изучить всю информацию из категории Конструирование и проектирование электронной аппаратуры
Комментарии
Оставить комментарий
Конструирование и проектирование электронной аппаратуры
Термины: Конструирование и проектирование электронной аппаратуры